○部品内蔵基板の技術範囲
部品内蔵基板の技術範囲には、能動部品、受動部品等をベース基板に搭載し 有機樹脂電子回路基板 材料で内蔵するタイプ、ベース上で部品形成して 有機樹脂電子回路基板材料で内蔵するタイプとが含まれる。 能動部品には、ベアダイ(bare die)、ウェーハレベルパッケージ(wafer-level package)、 BGA、LGA、QFNを含めた。受動部品にはチップ部品、複合チップ部品、IPDが入る。 モジュール、MEMSはパッケージングとモールディング後に内蔵される。
①ベースのシリコンや化合物半導体ウェーハを用い、ウェーハレベルでのチップスタック、
POP(Package on Package)又は再配線層に薄膜又は厚膜でデバイスを形成した後に部品内蔵基板を形成する。
②シートデバイスを使用し、有機材料基板上で素子を作り込んでから部品内蔵基板を形成する。
○基板構造
部品内蔵基板は、内蔵能動部品、受動部品等を搭載するベース(base)が必要である。
ベースの主流は、多層プリント配線板やビルドアップ多層配線板であるが、
絶縁樹脂、絶縁シート、金属板及びフィルムキャリアも使用できる。
○実装と接続
部品内蔵基板の接続方式には、ベース上に設けられた接続用のパッドに内蔵部品の端子を 接続する方式と、部品内蔵後に内蔵部品の端子上にビアを形成して接続する方式とがある。 従来の半導体実装工法及び表面実装工法でベースのパッドに接続させた後、埋め込みを行う。 また、能動部品、受動部品等を埋め込んだ後で、電子回路基板工法の銅メッキ又は導電ペーストで ビアと端子を接続するものである。
両方式とも部品搭載は、ダイボンディング方式と、マウンティング方式に分類できる
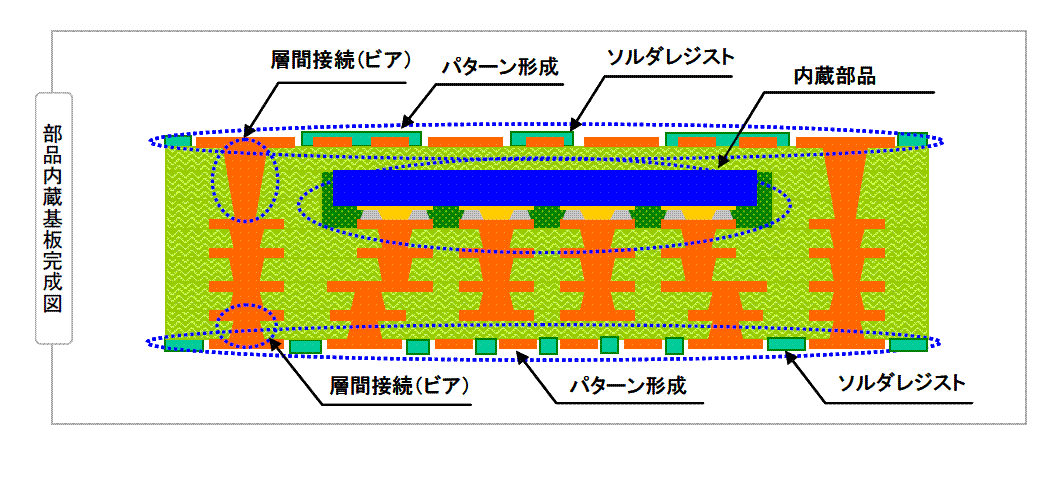

- 部品内蔵基板
- リジットフレキ基板
- 放熱基板
- 銅基板
- 高周波用基材
- セラミック基板
- 高熱伝道アルミベース基板(基材入り薄型高熱伝道材料)
- 部品内蔵電子回路基板
- メタル基板
- フレキシブル銅張積層板
- ビルドアップ多層プリント配線板
- ハロゲンフリー銅張積層板
- 部品内蔵基板
- 各種基材のお取り扱いについて
- パネルサイズ
- プリント配線板に使用する材料
- 電子回路基板
- プリント基板製作のお問い合わせ①
- プリント基板製作のお問い合わせ②
- プリント基板製作のお問い合わせ③
- プリント基板製作のお問い合わせ④
- プリント基板製作のお問い合わせ⑤
- プリント基板製作のお問い合わせ⑥
- プリント基板製作のお問い合わせ⑦
- フラックス
- ビルドアップ基板の層構成について
- SVHC 第14次追加物質
- AIS MSDSplus 管理対象物質リスト
- Vカットの深さ
- ハロゲンフリー基板
- インピーダンスコントロール
- アルミ基板について
- SVHC 第15次追加物質
- プリント基板の反り対策
- AIS MSDSplus 管理対象物質リスト 改定
- ソルダレジストの役割について
- ソルダレジストの工程について
- ソルダレジストの用途別タイプ
- フタル酸エステル系物質
- マーキングについて①
- マーキングについて②
- 導体パターン形成について
- プリント基板製造めっき工程
- 仕上がり銅箔厚について
- インピーダンス測定について
- CMRT 5.0について
- ワイヤーボンディングについて
- パターン間ギャップ
- 銅メッキ製造方法について
- プリント基板製作時に費用を抑える方法
- インピーダンスコントロール(テストクーポン)
- 薄い実装基板
- REACH 第18次SVHC追加8物質
- ユニバーサル基板製作
- リジットフレキ基板
- FR-4とCEM3の相違点
- AIS MSDSplus 管理対象物質リスト 最終改定




